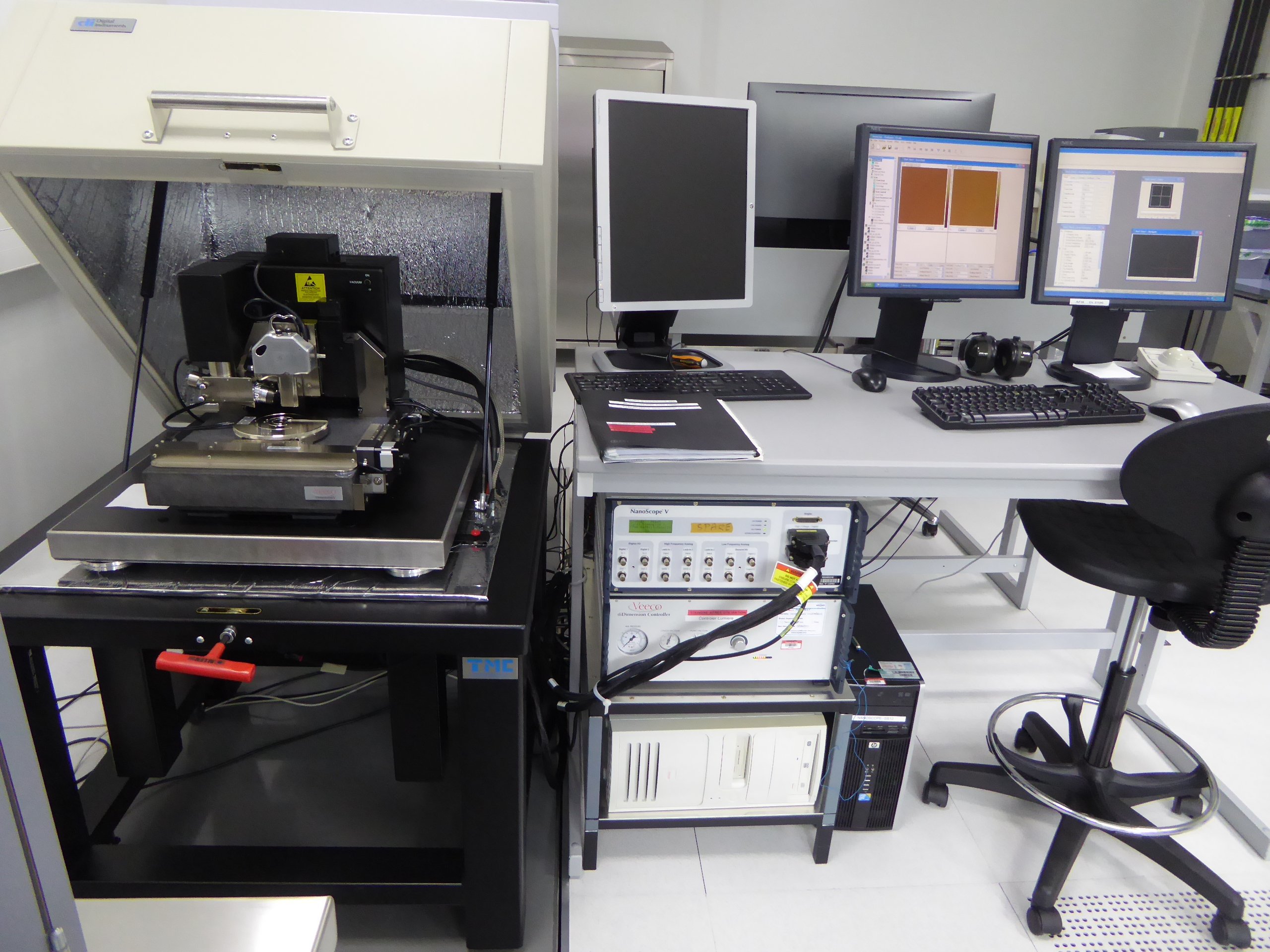

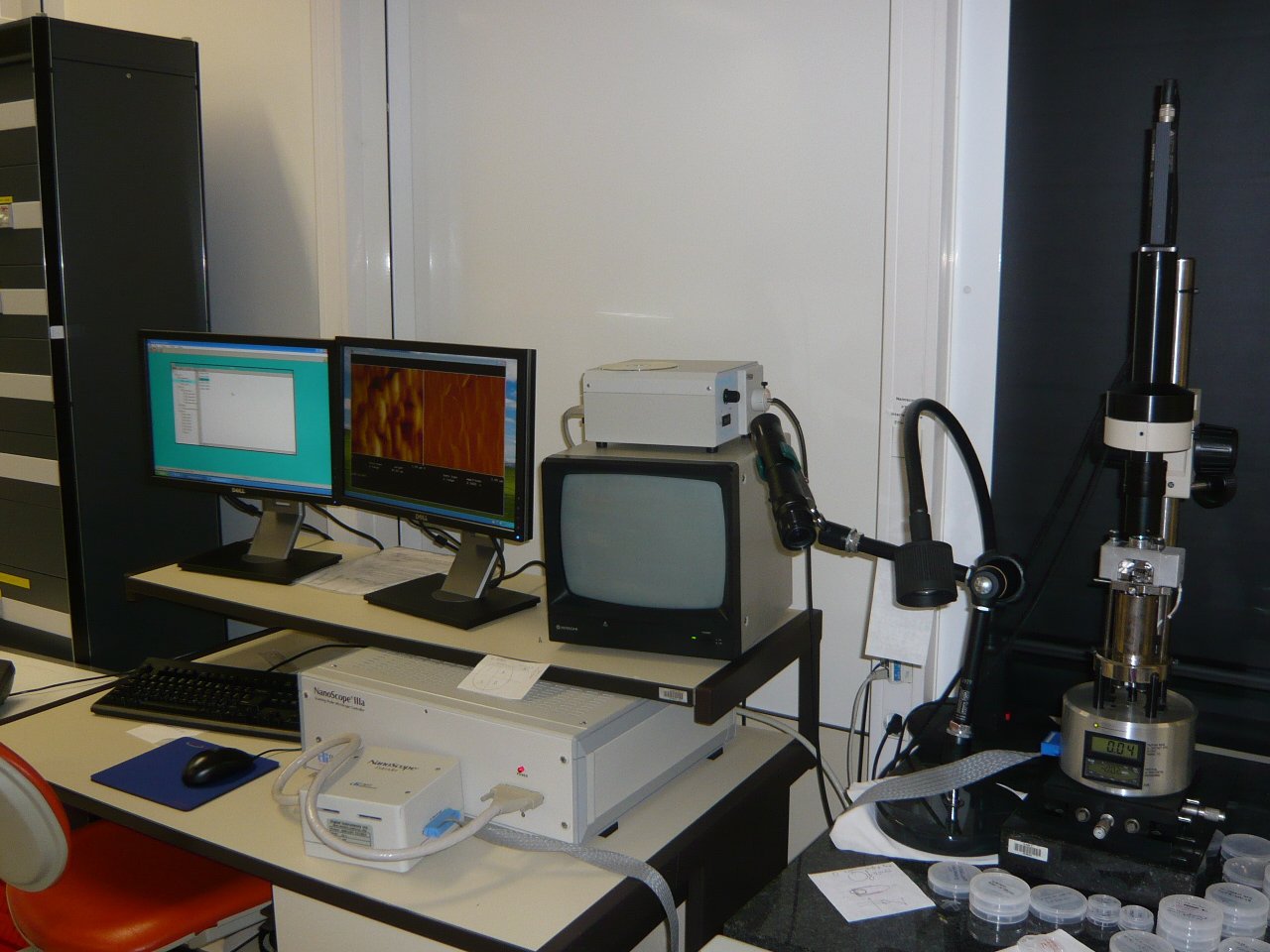

Nanofils GaAlAs/GaAs :
Structure Cœur-coquille de nanofils GaAs/GaAlAs enterrés dans une couche épitaxiée par MBE, analysée par AFM en section transverse. Nous mesurons l’épaisseur de la coquille AlGaAs.
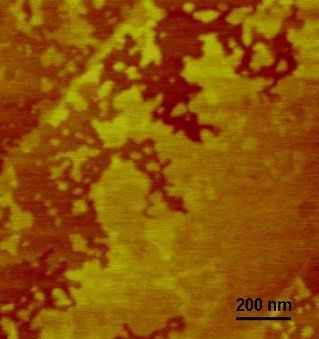
Couche de Graphène épitaxié :
Les couches sont formées par la sublimation d’un substrat de SiC. L’objectif est de progresser vers le contrôle de croissance de larges terrasses de graphène (1.0 µm).

Contrôle de dépôt métallique :
Morphologie de surface, rugosité et épaisseur d’une couche mince métallique par AFM. Rq = 2nm (image 3x3 µm). Optimisation du procédé de dépôt métallique pour couche très mince de film supraconducteur NbN (10 nm) deposée par pulvérisation.
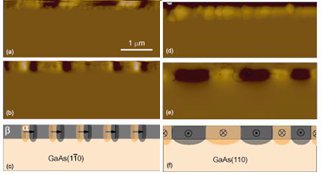
Structure de domaines magnétiques de MnAs/GaAs(001):
Les électrodes MnAs sur GaAs(001) se comportent comme des barreaux magnétiques classiques avec une forte anisotropie uniaxiale dans le plan. Cela favorise une configuration de domaines magnétiques ouverts qui a été observée par mesures MFM en section transverse de couche clivée MnAs/GaAs(001).

Intégration III/V sur Si :
Mesures I/V par AFM de nanocristaux de GaAs sur Si et nanofils enterrés (G. Hallais, Dpt Matériaux).
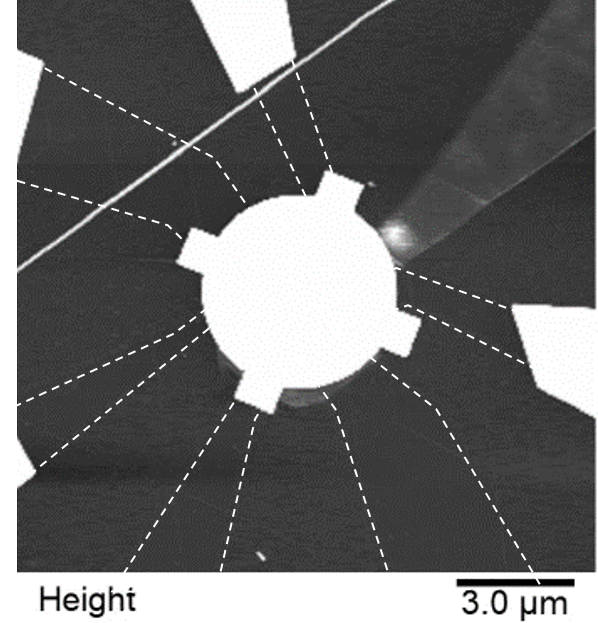
Nanomanipulation d'empilement de matériaux 2D :
Changement de l'angle entre different couches 2D (R. Ribeiro-Palau, Dpt. Nanoelectronic).